MOCVD装置
結晶成長データ例
結晶膜厚均一性基板上に形成される結晶の均一性は、リアクタ形状や基板加熱の均一性に影響を受けます。 
|
結晶純度結晶の純度は、装置の気密性や装置構成材料の影響を受けます。当社ではヒーター用部材等に脱ガスの少ない材料を用いて汚染を防いでいます。ノンドーブGaAs結晶の液体窒素温度(77K)でのホール測定結果は |
ヘテロ界面急峻性種類の異なった結晶境界面のダレを小さくするためには、ガス溜りのない構造と精密なガス制御技術が必要となります。GaAs基板上の単一量子井戸(SQW)構造でヘテロ界面の急峻性を評価しました。 |
||
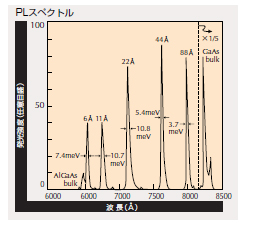 PLスペクトル |
 井戸幅に対するPLシフト |
|

